半導体の後工程「ボンディング工程」について丁寧に解説します
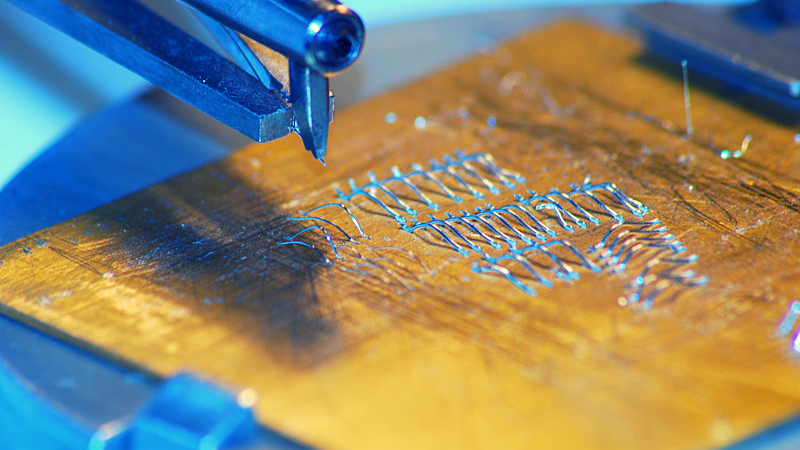
なぜボンディングをするのか?
ボンディングとは、金属の細い先で半導体チップ(ICチップなど)とリードフレームをつなぐことを指します。
そもそもなぜボンディングという工程を行う必要があるのでしょうか。
まずはそこから考えてみましょう。
ボンディングの主な機能は2つあります。
- 半導体チップとリードフレーム(Lead Frame;L/F)などの外部端子を電気的に接続するため
- 半導体チップと他の部材との応力を緩和するため
複数の異なる物質を接触させると、その物質の間には応力というチカラが自然と働きます。
勝手に働きます。
いい迷惑ですが、勝手に応力が働くので、緩和しないといけません。
緩和しないとチップが割れて、使い物にならなくなる可能性があるからです。
このボンディングの2つの機能を満足するために、ボンディングに使うボンディングワイヤの特性が大事になります。
ボンディングワイヤに求められる機能は以下の3つです。
- アルミパッドとの金属接合がかんたんなこと
- ループができるような金属で、ループができたあとに、高温にさらされてもループを維持する強度があること
- ボンディングのあとで行う封入工程の樹脂流動にも耐えて形を保持すること
これら3つの機能を満足する代表的な材料が、金(Au)です。
Auは、この世で最も酸化しにくい材料で、高温でも酸化しません。
また、Auはやわらかく、ループをつくることができます。
しかし、Auは柔らかすぎるので高温での強度に弱い傾向があるので、純粋なAuではなくAuにSiなどの添加物をいれて、硬さをちょっとだけアップさせた素材が使われています。
ただし、Auなので材料価格が高いのがネックです。
値段が高いので、Au以外のボンディングワイヤ材料も模索が進んでいます。
たとえば、Cu系のボンディングワイヤです。
Cuはすぐに酸化してしまいますが、酸化防止のために窒素ガスを添加したCuワイヤがあります。
窒素は空気中にもたくさん存在しているので、比較的安価に手に入るガスなのですが、ちょっと高価なArガスをCuに添加すると、より酸化がしにくくなり、強度も高いボンディングワイヤとして有用です。
最近で半、ボンディングパッド(ボンディングするパッド面)の大きさが小さくなってきており、それに合わせてボンディングワイヤの直径も細くなっています。
現在では、およそ20-25μm(1/1,000,000m) が実用レベルで使われているそうです。
細すぎて目では見えないかもしれません。











